電鍍又稱電沉積,是一種功能性金屬薄膜的制備方法。電鍍本質上屬于種電化學還原過程,即借助外電 場提供的電子,在所需的基材上將水溶液中的金屬離子還原成原子態金屬,并通過控制溶液中的金屬離子種類、存在形態、濃度、微量添加劑,以及溫度、電流密度、酸堿度、攪拌程度等,來調控沉積金屬的結晶形態、晶體取向、晶粒大小、表面平整度及金屬成分等,最終獲得所需要的具備特殊功能的金屬薄膜。
由于電鍍是以金屬薄膜制備為主,因此,在電子封裝中主要涉及各種金屬布線、焊盤、凸點,接插件中的電接觸鍍層等的制備。
電鍍具有以下優勢:配合各種光刻、掩模技術,可實現高密度、高精度金屬薄膜或線路制造;與物理/化學等氣相沉積技術相比,電鎮設備投資少、工藝簡單,可實現大規模低成本工業化制造;通過金屬種類的選擇和多層組合,可實現各種特殊功能,滿足產品需求。
在電子封裝中,電鍍工藝是必不可少的。針對不同的封裝,電鍍的加工精度和功能要求有所不同。
在傳統的引線框型(如 DIP、QFP、QFN、SOP、SON 等)封裝中,鍍銅、鑊銀、鍍鎳、鑊鈀和鑊金 主要用于銅或鐵鎳合金引線框架表面的處理,其目的是保證框架表面的可焊性、鍵合性和防護性。為了降低成本,貴金屬電鍍多采用局部電鍍。
球珊陣列型(如 BGA、FC-BGA 等)封裝所用到的有機封裝基板內部銅布線及Flip Chip表面再布線(RDL),生采用化學鑊銅與電鍍銅相結合的辦法來完成。表面的焊盤多需要鍍鎳打底,表面再鍍銀、鍍金或鎮錫,線寬一般在5~50μm 范圍內。
在圓片級封裝(WIP)中,除了表面再布線(RDL) 用到鍍銅、鍍鎳或鍍金,對于焊點密度較高的產品,焊接凸點(Bump)也是通過電鍍制作的,包括掩模鍍銅柱、鍍錫或鍍錫合金凸點。RDL 線寬一般為 1~25μm,Bump 高度可達 200μm。
隨著電 子封裝技術與產業的發展,電鍍在高密度制造、高精度制造和低成本制造方面將會發揮越來越大的作用。
審核編輯:劉清
-
DIP封裝
+關注
關注
1文章
41瀏覽量
13698 -
BGA
+關注
關注
5文章
551瀏覽量
47360 -
QFN封裝
+關注
關注
0文章
134瀏覽量
16899
原文標題:電鍍工藝,電鍍製程,Plating Proces
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
半導體晶圓電鍍工藝要求是什么
BNC連接器電鍍技術知識講解

BNC連接器使用電鍍技術的知識講解

陶瓷基板脈沖電鍍孔技術的特點
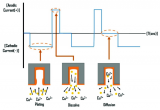
全球知名企業評測,PCB電鍍電解隔膜性能數據正式發布!

電鍍膜的性能測試方法
電鍍工藝流程詳解 電鍍技術在工業中的應用
HDI板電鍍與堆疊過程
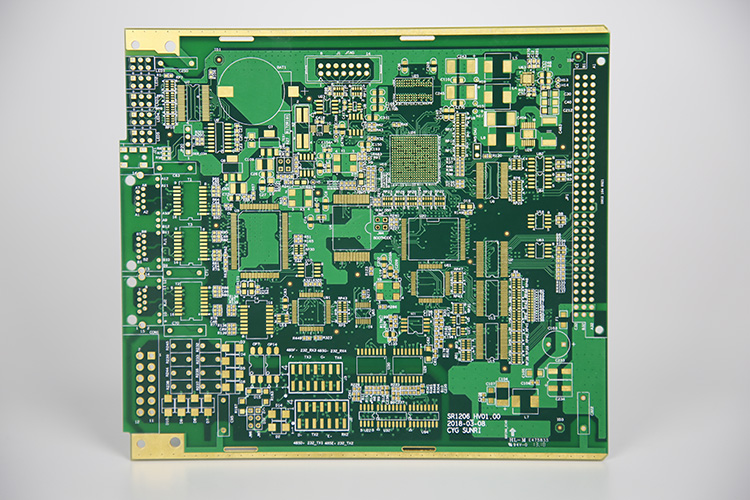




 電鍍工藝具有哪些優勢呢?
電鍍工藝具有哪些優勢呢?













評論