四面無引線扁平 (Ouad Flat No-lead Package, QFN)封裝屬于表面貼裝利封裝,是一種無引腳且星方形的封裝,其封裝四側(cè)有對外電氣連接的導(dǎo)電焊盤(引腳),引腳節(jié)距一般為 0.65mm、0.5mm、0.4mm、0.35mm。 由于封裝體外部無引腳,其貼裝面積和高度比 QFP 小。QPV 封裝底部中央有一個(gè)大面積外歸的導(dǎo)熱焊盤。QFN 封裝無鷗翼狀引線,內(nèi)部引腳與焊盤之問的導(dǎo)電路徑短,自感系數(shù)及體內(nèi)線路電阻低,能提供優(yōu)越的電性能。外露的導(dǎo)熱焊盤上有散熱通道,使 QFN 封裝具有出色的散熱性。
如下圖所示的分別是 WB-QFN ( Wire Bonding-QFN) 和FC-OFN(Filp Chip-QFN)基本結(jié)構(gòu)示意圖。這些結(jié)構(gòu)加上 MCP 技術(shù)和 SiP 等封裝技術(shù),為 QFN 的靈活多樣性提供了良好的 I/O 設(shè)計(jì)解快方案,也進(jìn)一步提高了封裝密度。

QFN 封裝工藝流程與傳統(tǒng)封裝的接近,主要差異點(diǎn)如下所述。
(1)QPN 產(chǎn)品框架在塑封前一般采取貼膜工藝,進(jìn)行球焊時(shí)的球焊參數(shù)模式與傳統(tǒng)的有差異,若控制不當(dāng),會(huì)造成焊線第2點(diǎn)的斷裂;另外,矩陣框架的塑封工藝必須采取多段注射方式來避免氣泡和沖線的發(fā)生。
(2)QFN產(chǎn)品的分離是采取切割工藝來實(shí)現(xiàn)的,切割過程中要采取合適的工藝(如低溫水)來避免熔錫,采用樹脂軟刀來減少切割應(yīng)力,采用合適的切割速度來避免分層等。
(3) QFN 產(chǎn)品通過選擇不同收縮率的塑封料來控制翹曲,不同厚度和大小的芯片需要選擇不同收縮率的塑封料。
(4) QFN 產(chǎn)品的框架均為刻蝕框架,框架設(shè)計(jì)包含應(yīng)力、抗分層、預(yù)防毛刺等考慮因素,框架設(shè)計(jì)的好壞決定著產(chǎn)品品質(zhì)的水平。傳統(tǒng)上芯(裝片)的 QFN 產(chǎn)品的生產(chǎn)工藝流程如下:

倒裝上芯的 QFN 產(chǎn)品的生產(chǎn)工藝流程如下:

隨著現(xiàn)代電子信息技術(shù)的飛速發(fā)展,對電子產(chǎn)品的小型化、便攜化、多功能、高可靠性和低成本等提出 了越來越高的要求,因 QFN 封裝可以很好地適應(yīng)了這個(gè)需要,所以其市場份額將會(huì)越來越大。
審核編輯:湯梓紅
-
SiP
+關(guān)注
關(guān)注
5文章
508瀏覽量
105626 -
封裝
+關(guān)注
關(guān)注
127文章
8159瀏覽量
143877 -
qfn
+關(guān)注
關(guān)注
3文章
192瀏覽量
56448 -
引腳
+關(guān)注
關(guān)注
16文章
1313瀏覽量
51377 -
焊盤
+關(guān)注
關(guān)注
6文章
562瀏覽量
38382
原文標(biāo)題:QFN 封裝工藝,QFN 封裝製程,QFN Process
文章出處:【微信號:Semi Connect,微信公眾號:Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
IC芯片的封裝工藝流程
倒裝晶片的組裝工藝流程
SMT組裝工藝流程的應(yīng)用場景(多圖)
SMT組裝工藝流程的應(yīng)用場景
【華秋干貨鋪】SMT組裝工藝流程的應(yīng)用場景
BGA的封裝工藝流程基本知識簡介
芯片封裝工藝流程是什么
芯片封裝工藝流程講解
博捷芯劃片機(jī):QFN封裝工藝流程揭秘及芯片切割分離技術(shù)及工藝應(yīng)用





 淺談QFN封裝工藝流程
淺談QFN封裝工藝流程
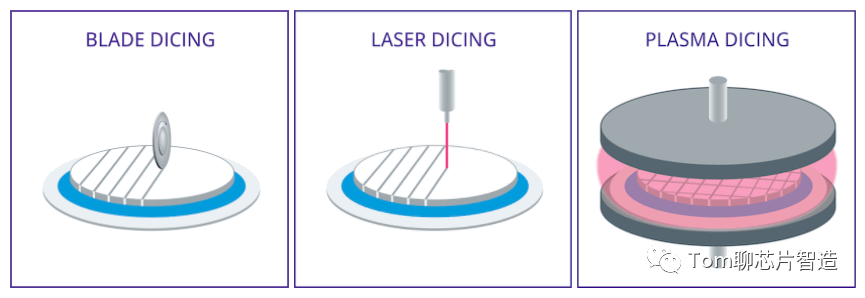












評論