芯片對(duì)于電子設(shè)備來(lái)說(shuō)非常的重要,進(jìn)口芯片在設(shè)計(jì)、制造和使用的過(guò)程中難免會(huì)出現(xiàn)失效的情況。于是當(dāng)下,生產(chǎn)對(duì)進(jìn)口芯片的質(zhì)量和可靠性的要求越來(lái)越嚴(yán)格。因此進(jìn)口芯片失效分析的作用也日漸凸顯了出來(lái),那么進(jìn)口芯片失效分析常用的方法有哪些呢?下面安瑪科技小編為大家介紹。
芯片失效是指芯片因?yàn)槟撤N原因?qū)е缕涑叽纭⑿螤罨蛘呤遣牧系慕M織與性能發(fā)生變化,從而不能完美地完成指定的功能。進(jìn)口芯片失效分析可以判斷進(jìn)口芯片失效的性質(zhì)以及分析出進(jìn)口芯片失效的原因,是研究進(jìn)口芯片失效的預(yù)防措施的技術(shù)工作。研究進(jìn)口芯片失效能夠起到非常大的作用,比如能夠提高進(jìn)口芯片的品質(zhì)以及改善生產(chǎn)方案。通過(guò)進(jìn)口芯片失效分析,可以非常及時(shí)地找出器件的缺陷或者是參數(shù)的異常,能夠追本溯源發(fā)現(xiàn)問(wèn)題所在,而且還能夠從根本上預(yù)防進(jìn)口芯片產(chǎn)業(yè)所出現(xiàn)的質(zhì)量危機(jī)。
檢測(cè)進(jìn)口芯片失效的方法有很多,比如外部目檢、x-ray檢測(cè)、聲學(xué)掃描以及開(kāi)封后sem檢測(cè)。外部目檢方法則是對(duì)進(jìn)口芯片進(jìn)行外部觀測(cè),判斷進(jìn)口芯片外觀是否存在裂紋、破損等異常的現(xiàn)象,對(duì)進(jìn)口芯片進(jìn)行x-ray檢測(cè),能夠通過(guò)無(wú)損害的手段利用X射線透視進(jìn)口芯片內(nèi)部,從而檢測(cè)其進(jìn)口芯片封裝情況,可以判斷進(jìn)口芯片封裝內(nèi)部是否出現(xiàn)各種缺陷問(wèn)題,比如分層剝離、鍵合線錯(cuò)位斷裂以及爆裂等。
進(jìn)口芯片聲學(xué)掃描方法是利用超聲波反射與傳輸?shù)奶匦耘袛喑銎骷?nèi)部材料的晶格結(jié)構(gòu)是否存在雜質(zhì)顆粒,并且能夠有效發(fā)現(xiàn)器件中是否存在裂紋,以及進(jìn)口芯片封裝材料內(nèi)部的氣孔和分層剝離等異常情況。進(jìn)口芯片開(kāi)封其實(shí)是一種有損的檢測(cè)方法,不過(guò)優(yōu)勢(shì)在于能夠剝除外部進(jìn)口芯片,在封膠之后觀察進(jìn)口芯片內(nèi)部結(jié)構(gòu)。
以上就是安瑪科技小編為大家分享的關(guān)于進(jìn)口芯片失效分析的全部?jī)?nèi)容了,希望可以幫助到大家。
審核編輯:湯梓紅
-
芯片
+關(guān)注
關(guān)注
459文章
51891瀏覽量
433196 -
電子元器件
+關(guān)注
關(guān)注
133文章
3453瀏覽量
107586 -
失效分析
+關(guān)注
關(guān)注
18文章
225瀏覽量
66780
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
電子元器件失效分析與典型案例(全彩版)
EBSD失效分析策略
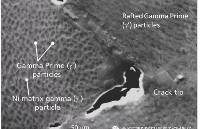
芯片的失效性分析與應(yīng)對(duì)方法

材料失效分析方法匯總

FIB技術(shù):芯片失效分析的關(guān)鍵工具

IV測(cè)試助力解芯片失效原因

季豐對(duì)存儲(chǔ)器芯片的失效分析方法步驟
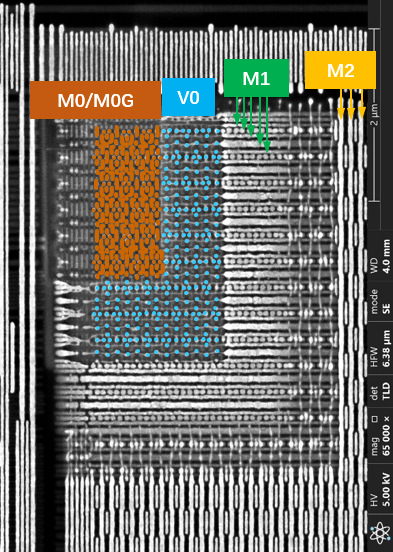
芯片失效分析中常見(jiàn)的測(cè)試設(shè)備及其特點(diǎn)
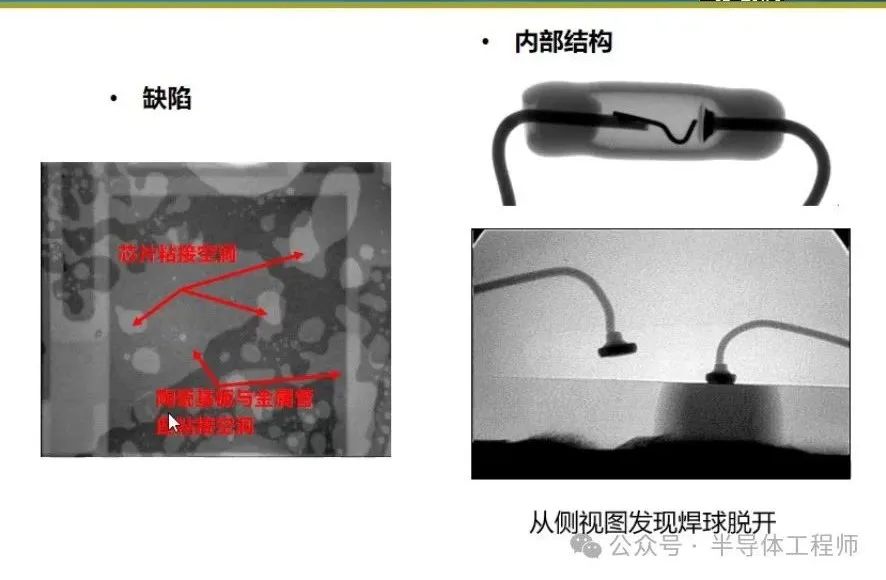
淺談半導(dǎo)體芯片失效分析Analysis of Semiconductor Chip Failure
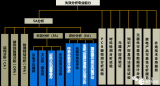









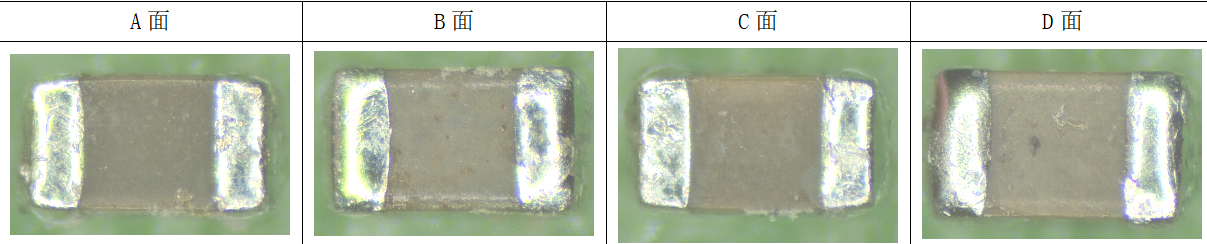











評(píng)論