作為目前碳化硅MOSFET型號最豐富的國產廠商派恩杰,不僅在功率器件性能上達到國際一流廠商水平,在AC BTI可靠性上更是超越國際一流廠商。總裁黃興博士用高性能和高可靠性的產品證明派恩杰是國產碳化硅功率器件的佼佼者,展現了超高的碳化硅設計能力和工藝水平。
背景
在功率器件半導體領域,越來越需要高頻高功率耐高溫的功率器件,隨著時間發展,硅材料在功率器件領域已經達到了材料性能的極限,碳化硅憑借其材料的優越特性開始大放異彩,然而新材料帶來的可靠性問題是急需解決的。其中AC BTI(Bias Temperature Instabilities)即交流高溫偏置不穩定性是碳化硅新材料帶來的一大問題。
碳化硅的生產制造具有很多挑戰,比如碳化硅晶圓表面更粗糙,直徑更小,硬度接近金剛石,透明度更高;比如需要開發新的制造工藝,高溫摻雜激活退火、歐姆接觸形成和新的界面鈍化方案等。為了成功認證汽車級或工業級可靠性標準,必須了解和評估與傳統硅技術不同的SiC MOSFET的新特性,并且解決此類可靠性問題。SiC 特有的挑戰在某種程度上與柵極氧化物可靠性有關,(1)早期柵極氧化物擊穿;(2)閾值電壓不穩定性。
第一個可靠性問題可通過智能篩選、TDDB(Time-Dependent Dielectric Breakdown)試驗和馬拉松試驗,智能篩選措施可以將SiC MOSFET降低至與Si MOSFET相同等級的低故障率,此前已通過《TDDB試驗》證明派恩杰SiC MOSFET壽命遠超20年,通過《馬拉松試驗》證明在正常運行20年的時間內派恩杰SiC MOSFET失效PPM為個位數。
第二個可靠性問題,閾值電壓不穩定性,分為PBTI、NBTI和AC BTI。直流的閾值電壓不穩定性即PBTI和NBTI使用傳統的可靠性測試方法HTGB(High Temperature Gate Bias)即可測試,經過驗證派恩杰SiC MOSFET的PBTI和NBTI可靠性達到國際一流廠商水平。而AC BTI由于業界尚未有明確的測試方法,是一項較為前沿的研究。本文講述AC BTI測試下的閾值電壓不穩定性問題。
如今SiC MOSFET已經大量在電動汽車和光伏等領域使用,說明目前的SiC MOSFET可靠性已遠超十年前的水平,達到了車規級和工業級的可靠性水平。
物理機理
閾值電壓不穩定性分為非本征閾值電壓不穩定性和本征閾值電壓不穩定性,通常與宏觀缺陷或雜質無關。
非本征閾值電壓不穩定性是由于離子污染物(例如鈉或鉀)可能在器件制造期間或在正常器件操作期間從外部進入柵極氧化物。防止移動離子進入柵氧化層或在器件加工過程中清除它們的程序對于Si MOSFET技術已經非常成熟。檢測和消除的專有技術和經驗可以直接應用于SiC MOSFET。
另一方面,本征閾值電壓不穩定性與界面的物理性質有關,即界面態和邊界陷阱的密度以及它們與半導體襯底交換電荷載流子的能力。盡管SiC是唯一擁有高質量原生氧化物的寬帶隙半導體,但SiC/SiO2界面的缺陷密度比Si/SiO2界面高兩個數量級左右。
這不僅是由于更寬的帶隙和更窄的帶隙對電介質的偏移,而且還因為空位和碳相關的點缺陷僅存在于SiC。為了鈍化這些新的缺陷類型,必須開發替代的氧化后鈍化方案。不同的界面特性會導致SiC MOSFET的傳輸特性出現新的特征。大多數這些新特性都可以通過簡化的物理模型來理解,這樣可以更好地理解過程相關性,并有助于正確設置和評估壽命測試的結果。
試驗方法
AC BTI測試方法,功率器件DUT Vgs=-5/20V,?=10k~1MHz,DS短接,DUT加熱至175℃,見圖1。

圖1. 測試原理
電路采用多顆隔離驅動IC驅動多顆功率器件,需要合理Layout驅動電路,采用較短的連接線等,避免由于尖峰對器件帶來的影響。在考慮以上因素后,驅動電阻設置稍大電阻值保證Vgs波形的尖峰較小,Vgs實測波形見圖2。
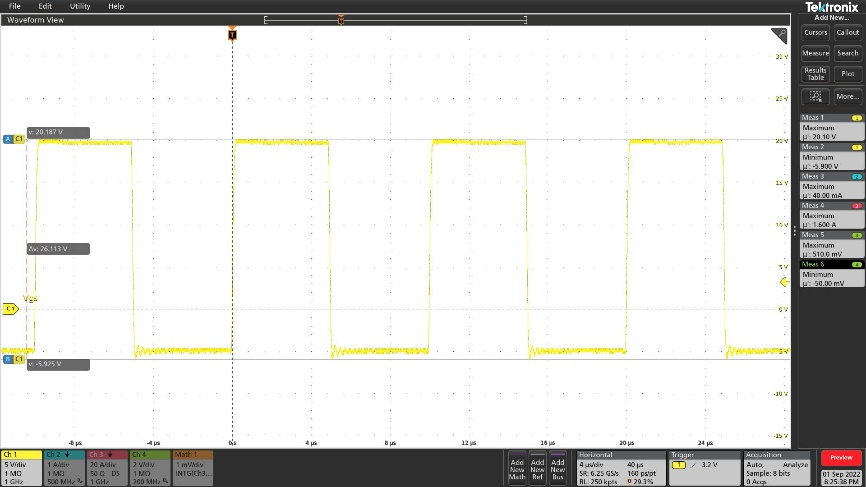
圖2. Vgs波形
試驗方法采用MSM (Measure-Stree-Measure) 測試方法,見圖3。其中Vstress time=1~200ks。
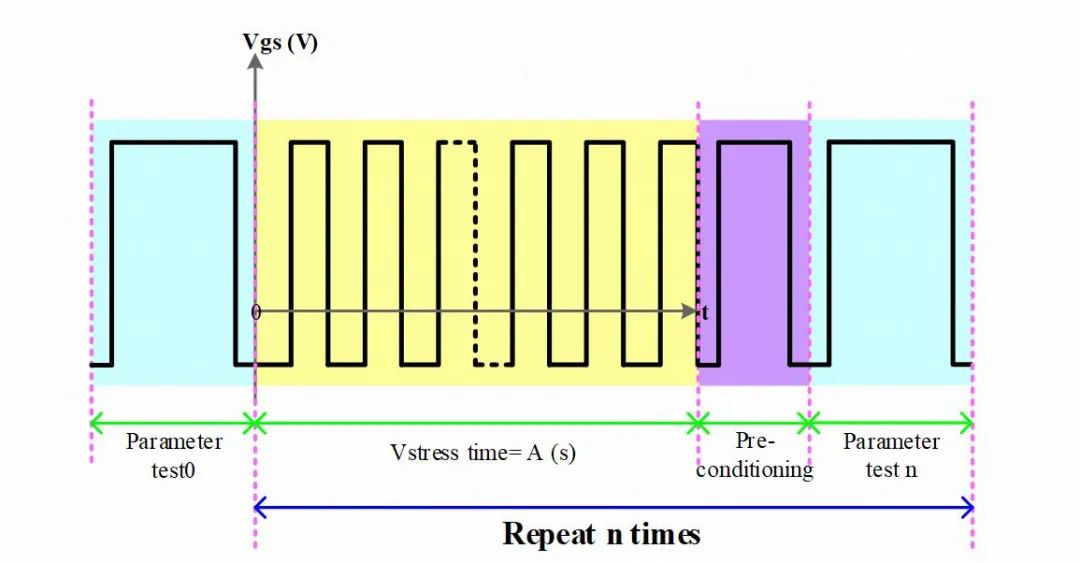
圖3. MSM測試方法
由于碳化硅與二氧化硅界面缺陷密度更高,碳化硅MOSFET的Vth存在更大的瞬態漂移值,經過大量的實驗驗證Vth瞬態漂移值不會對電路造成太大的影響,因此需要準確測量到Vth的永久漂移值。
使用JEDEC標準JEP184中的Vth滯后方法測試,見圖4。其中Vgs=20V,-Vgs=-20V,t_precon=100ms,t_float=10ms,t_meas=2.5ms。Vth值以Vth_Down為準,因為采用了預施加壓力后,Vth的瞬態漂移值已消除。采用此方法進行測試,實現了可重復快速準確測試Vth值,與初始值比較可得到Vth的永久漂移值。
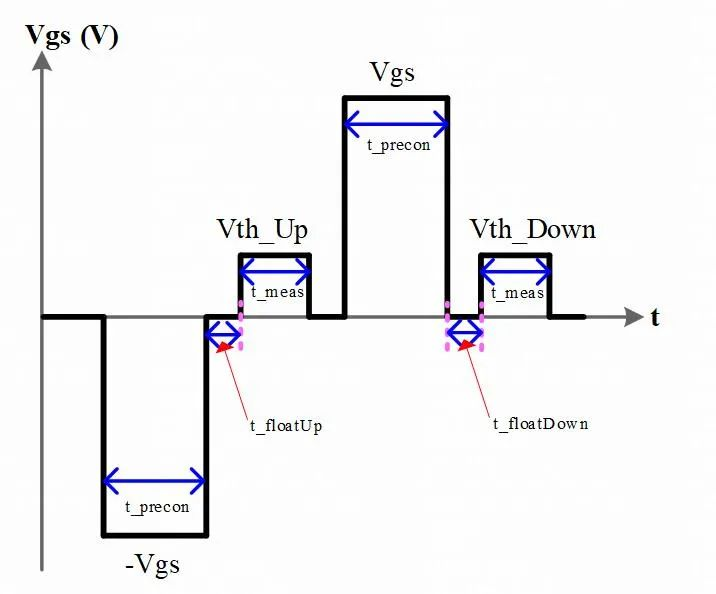
圖4. 滯后Vth測量方法
試驗結果
試驗條件:Vgs=-5/20V,DS Short,?=100kHz,占空比δ=50%,T=175℃;器件1#~4#為派恩杰公司1200V80mΩ SiC MOSFET-P3M12080K3,器件5#為C公司同規格等級平面柵SiC MOSFET,器件6#為I公司同規格等級溝槽柵SiC MOSFET。試驗結果Vth永久漂移值對比圖見圖5, Rdson變化率對比圖見圖6,實線圓點表示1000h數據,虛線表示外推至20年變化值。
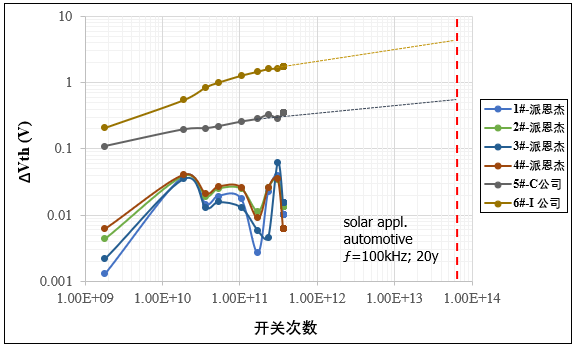
圖5. AC BTI VTH永久漂移值對比
1000h的AC BTI試驗Vth永久漂移值結果:派恩杰器件1#~4#的Vth永久漂移值均小于0.1V,C公司器件5#的Vth永久漂移值為0.1~0.3V,I公司器件6#的Vth永久漂移值為0.2~1.6V。可以看出派恩杰器件Vth永久漂移值均較小且一致性較好,優于平面柵的C公司器件。溝槽柵的I公司器件Vth永久漂移值最大,得出結論溝槽柵的SiC MOSFET功率器件Vth永久漂移值大于平面柵的SiC MOSFET。
派恩杰器件Vth永久漂移值幾乎不隨開關次數變大,沒有明顯的增長,C公司器件與I公司器件Vth永久漂移值隨開關次數符合冪律關系。C公司器件Vth永久漂移值外推至20年可能會達到0.6V左右。I公司器件Vth永久漂移值外推至20年可能會達到4V左右。
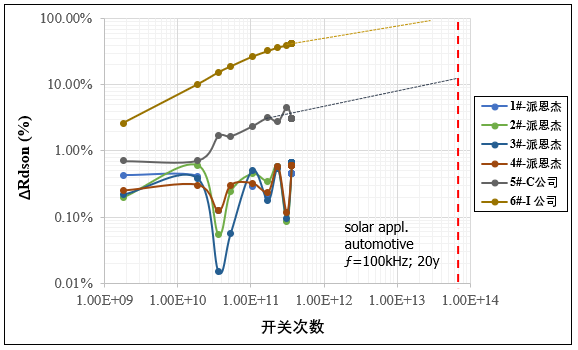
圖6. AC BTI Rdson變化率對比
1000h的AC BTI試驗Rdson變化率結果:派恩杰器件1#~4#的Rdson變化率均小于1%,C公司器件的Rdson變化率為0.7%~4.6%,I公司器件的Rdson變化率為2.6%~40%。可以看出派恩杰器件1#~4#的Rdson變化率均較小,且不隨時間推移變化,性能穩定,幾乎達到硅MOSFET可靠性水平,明顯優于C公司與I公司器件可靠性水平。
派恩杰器件Rdson不隨開關次數變化,C公司器件Rdson變化率外推至20年可能會達到10%左右,I公司器件Rdson變化率外推至20年可能會超過100%左右。
考慮到功率器件的實際應用工況會更加復雜,可靠性問題可能會出現更為惡劣的情況,功率器件在實際工況的參數漂移可能會更大。
應用影響
若功率器件的性能不穩定發生漂移,輕則降低轉換器效率,重則導致轉換器炸機。器件性能的漂移會降低器件本身的使用壽命,甚至可能會導致一些災難性的后果。特別是在功率芯片并聯領域,比如模塊,芯片的參數發生漂移,可能導致并聯不均流,模塊更容易損壞或者壽命更短。從上述可靠性試驗結果來看,派恩杰的SiC MOSFET性能是最穩定的,最適合用于并聯的。
結論
作為一種更接近實際應用的可靠性測試方法,AC BTI能夠更加準確的評估SiC MOSFET芯片的可靠性,是SiC MOSFET必不可少的可靠性測試項目之一。在同等試驗條件下,平面柵的SiC MOSFET的AC BTI可靠性優于溝槽柵的可靠性,派恩杰SiC MOSFET的AC BTI可靠性優于國際一流廠商C公司和I公司,派恩杰的SiC MOSFET功率器件設計和工藝能力優于國際一流廠商C公司和I公司。派恩杰碳化硅MOSFET是全球碳化硅功率器件可靠性最高和性能最穩定的碳化硅功率器件之一。

關于派恩杰
第三代寬禁帶半導體材料前沿技術探討交流平臺,幫助工程師了解SiC/GaN全球技術發展趨勢。所有內容都是SiC/GaN功率器件供應商派恩杰半導體創始人黃興博士和派恩杰工程師原創。
黃興博士
派恩杰 總裁 技術總監
美國北卡州立大學博士,師承Dr. B. Jayant Baliga(IEEE終身會員,美國科學院院士,IGBT發明者,奧巴馬授予國家技術創新獎章)與Dr. Alex Q. Huang(IEEE Fellow, 發射極關斷晶閘管(ETO)的發明者)。10余年碳化硅與氮化鎵功率器件經驗,在世界頂尖碳化硅實驗室參與美國自然科學基金委FREEDM項目、美國能源部Power America項目,曾任職于Qorvo Inc.、聯合碳化硅。2018年成立派恩杰半導體,立志于幫助中國建立成熟的功率器件產業鏈。
派恩杰半導體
成立于2018年9月的第三代半導體功率器件設計和方案商,國際標準委員會JC-70會議的主要成員之一,參與制定寬禁帶半導體功率器件國際標準。發布了100余款650V/1200V/1700V SiC SBD、SiC MOSFET、GaN HEMT功率器件,其中SiC MOSFET芯片已大規模導入國產新能源整車廠和Tier 1,其余產品廣泛用于大數據中心、超級計算與區塊鏈、5G通信基站、儲能/充電樁、微型光伏、城際高速鐵路和城際軌道交通、家用電器以及特高壓、航空航天、工業特種電源、UPS、電機驅動等領域。
文章來源:派恩杰半導體
審核編輯 黃宇
-
IC
+關注
關注
36文章
6035瀏覽量
177319 -
功率器件
+關注
關注
42文章
1843瀏覽量
91304 -
SiC
+關注
關注
30文章
3030瀏覽量
63683 -
碳化硅
+關注
關注
25文章
2928瀏覽量
49670
發布評論請先 登錄
相關推薦
SiC模塊解決儲能變流器PCS中SiC MOSFET雙極性退化失效痛點
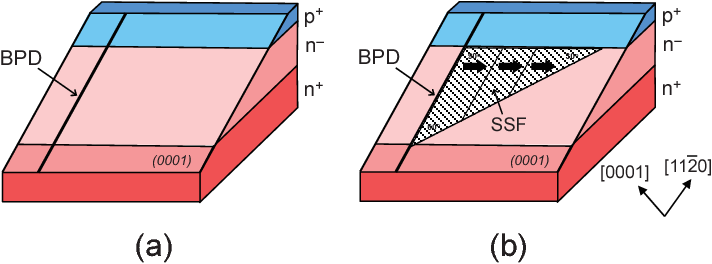
40mR/650V SiC 碳化硅MOSFET,替代30mR 超結MOSFET或者20-30mR的GaN!
什么是MOSFET柵極氧化層?如何測試SiC碳化硅MOSFET的柵氧可靠性?
瞻芯電子參與編制SiC MOSFET可靠性和動態開關測試標準

瞻芯電子交付碳化硅(SiC)MOSFET逾千萬顆 產品長期可靠性得到驗證

瞻芯電子第三代1200V 13.5mΩ SiC MOSFET通過車規級可靠性測試認證

AC/DC電源模塊可靠性是確保設備長時間穩定運行的關鍵因素

AC/DC電源模塊的可靠性設計與測試方法

SiC MOSFET短路失效的兩種典型現象

























評論