文章來源:半導體與物理
原文作者:jjfly686
Bosch刻蝕工藝作為微納加工領域的關鍵技術,對于HBM和TSV的制造起到了至關重要的作用。
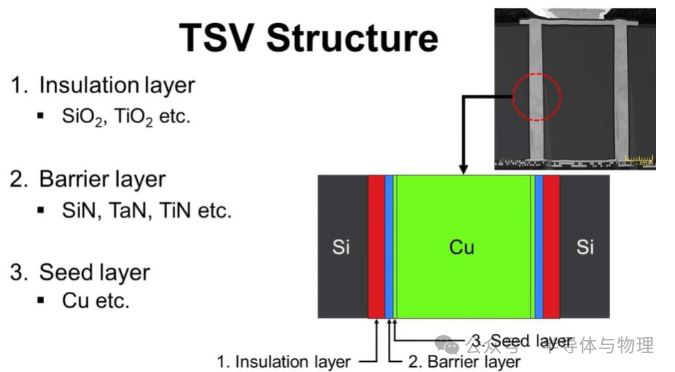
HBM是一種先進的3D堆疊內存技術,通過將多層DRAM芯片垂直堆疊并使用硅通孔(TSV)技術連接,實現了顯著的帶寬提升和功耗降低。HBM技術在高性能計算、圖形處理和人工智能等領域有著廣泛的應用。Bosch刻蝕工藝作為微納加工領域的關鍵技術,對于HBM和TSV的制造起到了至關重要的作用。
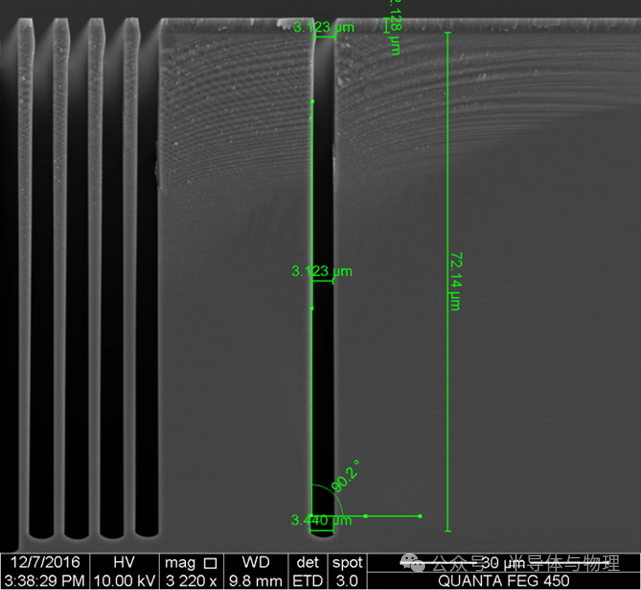
在HBM制造過程中,Bosch刻蝕工藝主要用于形成TSV結構。TSV技術要求在硅基板上刻蝕出深且直的孔洞,以便在不同層之間建立電氣連接。Bosch刻蝕工藝的高深寬比和高精度特性使其成為制造TSV的理想選擇。
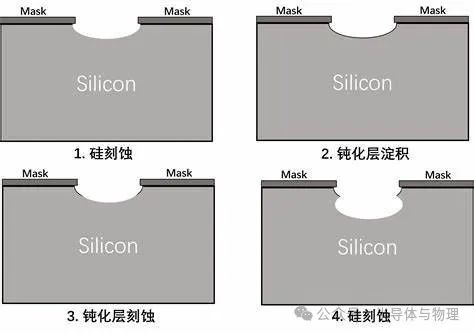
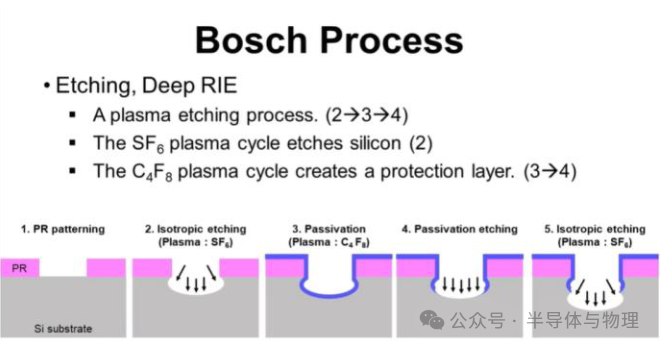
1. 基礎刻蝕階段 (Bosch I 階段)
目的:去除硅材料,形成初始的溝槽或孔洞。
過程:使用SF6(六氟化硫)作為主要刻蝕氣體,通過等離子體放電產生氟自由基和離子。這些活性物種與硅表面發生化學反應,形成揮發性的SiF4(四氟化硅),從而去除硅材料。為了提高刻蝕的選擇性和速率,有時會加入少量的氧氣(O2)以促進副產物的清除。
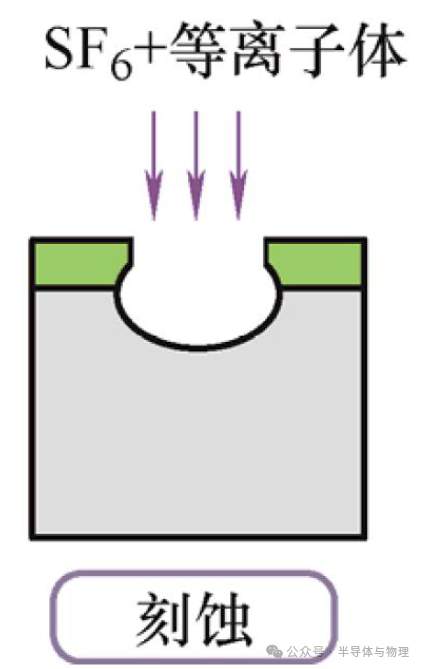
2. 側壁保護階段
目的:在溝槽或孔洞的側壁形成保護層,防止后續刻蝕過程中側壁的侵蝕。
過程:切換到C4F8(八氟環丁烷)作為主要氣體。C4F8在等離子體作用下分解并沉積于溝槽側壁,形成一層聚合物保護膜。這層膜有效地阻止了后續刻蝕過程中側壁的進一步侵蝕,確保了溝槽的直立性和結構的穩定性。

3. 側壁刻蝕階段 (Bosch III 階段)
目的:去除溝槽底部的硅材料,同時保持側壁保護層的完整性。
過程:再次切換回SF6為主的刻蝕氣體環境,針對已經形成的側壁保護層進行局部刻蝕。由于保護層的存在,只有暴露在外的硅材料會被有效移除,而溝槽底部及側壁則受到保護,維持原有的形態。此階段的關鍵在于精確控制刻蝕條件,避免對側壁造成不必要的損傷。
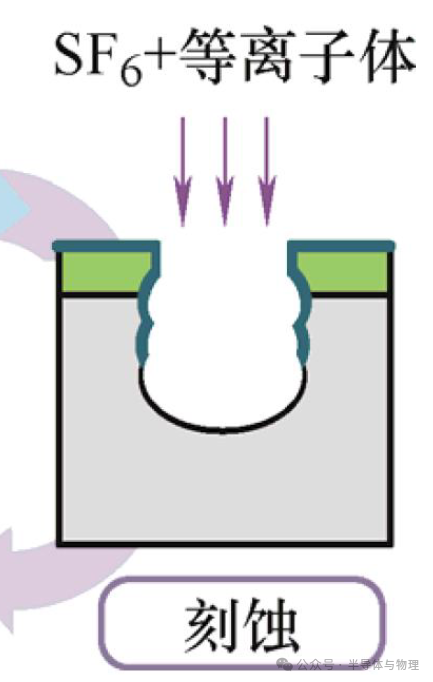
4. 重復循環
目的:通過多次循環,逐步加深溝槽或孔洞的深度,直至達到設計要求。
過程:上述三個階段構成了一個完整的刻蝕-沉積-再刻蝕周期。每個周期中,側壁保護層的形成與去除是確保結構完整性的關鍵步驟。根據所需的刻蝕深度和形狀,可以重復進行多個周期,實現更加復雜和精確的結構。
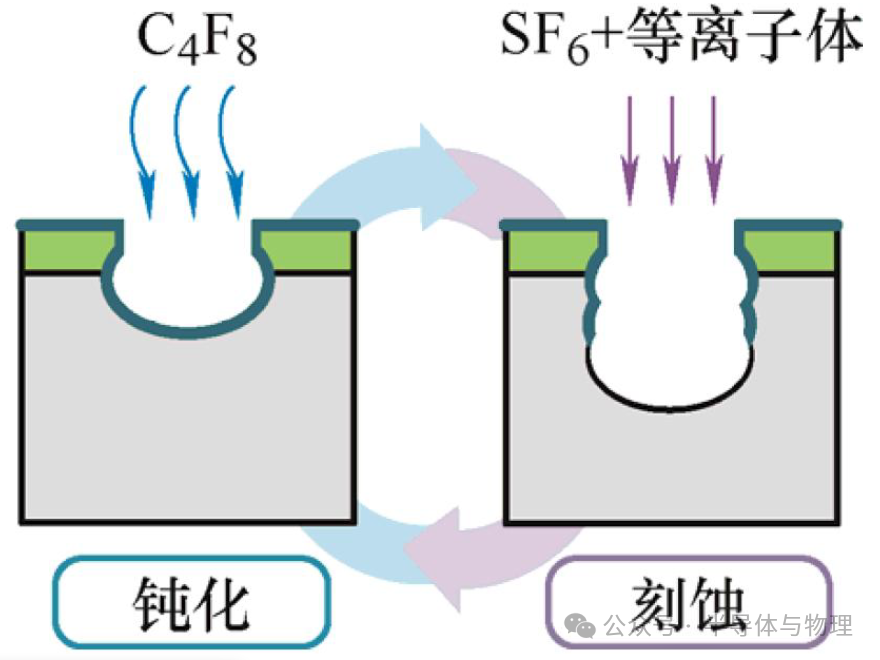
Bosch刻蝕工藝的優勢
高深寬比:Bosch工藝能夠實現高達幾十微米甚至幾百微米的深寬比,適用于制造深且直的TSV孔洞。
高精度:通過精確控制刻蝕條件,Bosch工藝能夠確保孔洞的垂直度和平滑性,提高TSV的可靠性和性能。
高選擇性:Bosch工藝能夠選擇性地刻蝕硅材料,而不損壞其他材料,確保了TSV結構的完整性和穩定性。
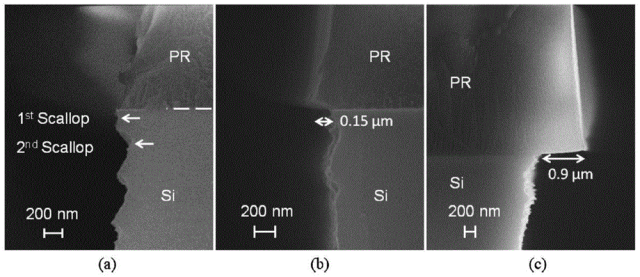
-
工藝
+關注
關注
4文章
641瀏覽量
29111 -
BOSCH
+關注
關注
14文章
57瀏覽量
54609 -
刻蝕工藝
+關注
關注
2文章
38瀏覽量
8527
原文標題:Bosch 工藝
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
芯片制造的刻蝕工藝科普
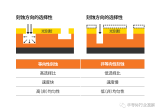
【「大話芯片制造」閱讀體驗】+ 芯片制造過程和生產工藝










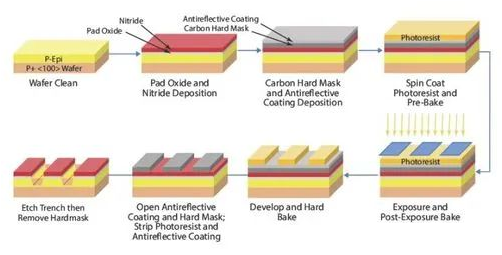















評論